How to Recover The Multimillion-Euro Yield Gap
Date Section Blog
In our previous article, we discussed how uncertainty in sampling-based manual review leads to conservative decisions. We explored why those decisions result in unnecessary scrap and where operational bottlenecks occur, highlighting how yield loss is driven by how review is performed.
This article moves on to quantify the financial and operational impact of a more scalable review approach, using a representative high-volume production scenario. It shows how sampling-based review structures create structural over-scrap, and how a deep learning inspection layer combining classification, defect analysis, and decision support can enable more consistent, full-coverage review.
The result is recovery at scale: a clear, multimillion-euro yield recovery opportunity, achieved by improving how review decisions are made.

Starting Point: A Typical High-Volume Fab
Starting with a representative production scenario helps illustrate the financial impact. For example, consider a high-volume fab running at 730,000 wafer starts per year.
Wafers are typically processed in lots of 25. Due to throughput constraints, only a small subset (often around four wafers per lot) is reviewed manually. Decisions about the remaining wafers are then inferred from this limited sample.
In practice, this means that four wafers are used to make decisions about the remaining twenty-one. The review process does not observe the full lot, but still determines its disposition.
This structure is common across modern fabs. Inspection systems operate at scale, but review capacity does not. As a result, decision-making relies on partial visibility. And this is where the yield problem starts.
Where Yield Loss Occurs
When anomalies are identified in sampled wafers, the outcome is rarely isolated to those wafers alone. Decisions are applied at the lot level. If defects are confirmed in the reviewed sample, the remaining wafers in the lot are often treated conservatively.
The outcome depends on the binning rule used in the fab. For example, rules such as “any reviewed wafer defective” or “at least two of three wafers defective” can trigger lot-level containment based on a small sample. The probability of triggering such a rule depends on the underlying defect footprint, but the resulting action typically applies to the entire lot. So in a typical scenario:
Good wafers can be discarded simply because they were never individually assessed. Over time, this creates a structural yield loss mechanism. At €1000 per wafer, this translates into a multimillion-euro problem embedded in daily operations.

Quantifying Yield Recovery Impact
With full-coverage AI-assisted evaluation, each wafer is assessed individually. Lot-level generalization is no longer required, and good wafers can be preserved.
Assuming a conservative AI accuracy of 90%, a large share of this structurally over-contained volume can be recovered. This translates into approximately 7,600 wafers recovered annually, representing over €3.8 million in recovered yield.
This primary value driver comes from removing a structural inefficiency in how decisions are made. Closing the gap requires more than a single application; it requires a review layer that can combine automated defect classification with precise localization, measurement, and pattern analysis across wafers and lots. Together, these capabilities create a more complete basis for decision-making than manual sampling alone.
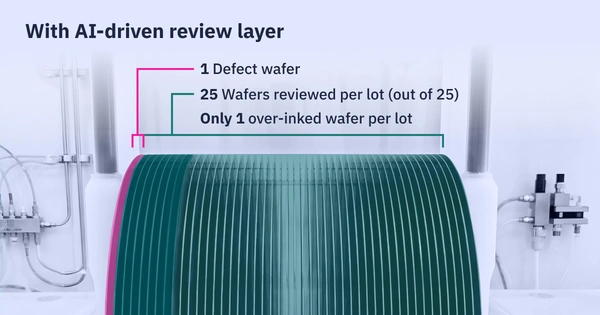
Additional Sources of Value
The financial impact extends beyond yield recovery alone. A portion of detected defects are nuisance signals that do not affect functionality but still influence conservative decisions. With AI-supported review, nuisance signals can be handled more consistently, reducing their influence on conservative scrap decisions. When localization, segmentation, and classification work together, however, teams gain better visibility into which signals matter, which do not, and where recurring patterns emerge. In this scenario, that contributes an additional ±€197,000 in recovered value.
There is also an operational effect. Manual review is resource-intensive, often requiring continuous staffing. By reducing the volume of cases requiring human intervention, AI-supported review allows review capacity to be reallocated. Even a partial reduction in manual workload can translate into meaningful efficiency gains and enable faster decision cycles.
This advantage is particularly relevant in high-throughput environments, where review capacity does not scale with inspection load and creates structural bottlenecks. The shift also allows experienced engineers to focus on higher-value tasks, rather than processing large volumes of routine classifications, resulting in ±€570,000 unlocked labor value.
When these elements are combined, the financial implications are clear:
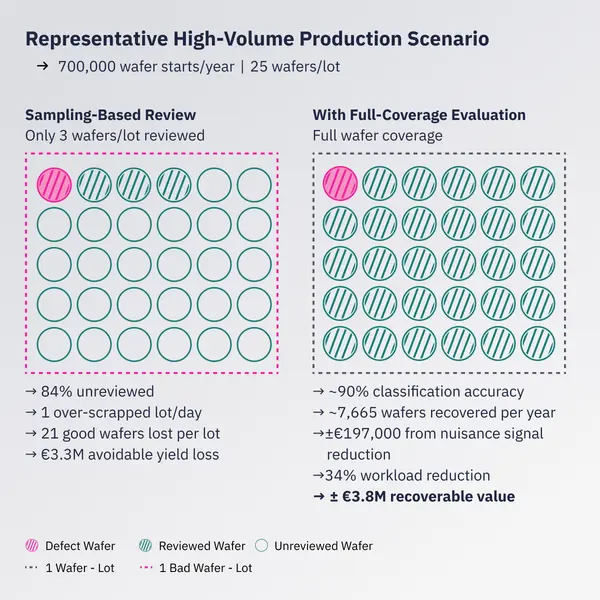
Ready to quantify your yield recovery opportunity?
While the exact value will depend on review coverage, binning rules, defect behavior, and wafer value, the underlying opportunity structure remains the same. To quantify your own yield opportunity, use our interactive ROI Calculator and discover the recoverable value in your own fab.
Strategic Implications Beyond the Numbers
The financial case is compelling, but the operational implications are just as important. A software-driven review layer enables wafer-level decision-making, reducing reliance on conservative assumptions.
This capability is especially relevant in automotive environments, where strict quality requirements amplify conservative decision-making, and in SiC and power devices, where higher defect variability increases ambiguity.
Classification becomes more consistent across shifts, tools, and fabs. Additional analytical capabilities improve visibility into defect behaviour and yield impact, enabling inspection to scale without introducing new review bottlenecks. Fabs can also increase AOI sensitivity without increasing downstream constraints.
This approach creates a structured decision record that supports root cause analysis, process control, and continuous model improvement. As more decisions are processed, performance can be monitored, with drift detection and targeted data capture sustaining value as conditions evolve. This improvement should not require changes to existing inspection systems or MES workflows; the value comes from improving how data is interpreted, rather than how it is generated.
From Sampling to Full-Coverage Review
As discussed, yield loss is not driven by defect density alone. It is impacted by how review decisions scale. As inspection outpaces human capacity, sampling introduces uncertainty, which in this context is not abstract.
Uncertainty is created because only a small fraction of wafers is observed. Decisions are made based on incomplete evidence, increasing the likelihood of conservative, lot-level actions.

Instead of extrapolating from three wafers, decisions can be made based on all wafers in the lot. And rather than inferring lot-level outcomes from a small subset, each wafer can be evaluated with greater consistency and context. Defects can be classified and nuisance patterns separated more reliably, enabling broader spatial behaviours to be understood earlier.
A Multi-Application Approach to Defect Review
Achieving consistent, full-coverage review at scale requires more than a single capability. It depends on a set of complementary applications working together within a unified inspection and decision layer.
Automated Defect Classification (AI ADC)
Enables consistent categorisation of defects at scale, reducing reliance on manual sampling and improving decision consistency across wafers, lots, production lines, and fabs:
Segmentation
Provides precise localization and measurement of defects, allowing teams to distinguish between critical and non-critical features with greater accuracy.
Spatial Signature Analysis
Identifies recurring defect patterns across wafers and lots, supporting faster root cause analysis and improved process control.
Scaling with Flexible Lightweight Agents
Allows capabilities to be deployed and adapted across tools and use cases without heavy integration overhead, supporting scalable adoption.
An Industrial Deep Learning Vision Infrastructure Layer
Provides a governed foundation for deploying and managing models across the fab, ensuring consistency and long-term performance.
Efficient Review
Reduces the volume of manual inspection by focusing human expertise on edge cases and validation, improving throughput and decision speed.
Data Drift Monitoring
Ensures performance is sustained over time by detecting changes in data patterns and enabling targeted data capture and model updates.
Together, these capabilities form a deep learning inspection layer that directly ties inspection performance to measurable business outcomes, including higher yield, reduced scrap, lower cost of quality, and less time spent reviewing samples.
From Financial Model to Production Reality
The €3.8M scenario is one example based on a specific production profile. Yet the pattern is widely applicable. Wherever sampling drives decisions and uncertainty drives conservatism, there is recoverable yield.
Where a small number of reviewed wafers determines the fate of the entire lot, there is structural over-containment. This value is often hidden, distributed across thousands of small decisions made every day.
In the next article, we discuss how Robovision’s production-grade deep learning inspection layer is operationalized within the fab, providing predictable value over time. We discuss how this fits into existing production, with a review layer that operates on existing fab infrastructure and fully utilizes existing inspection investments.
Ready to improve yield loss from review bottlenecks? Let’s talk.
Or to learn more about replacing sampled decisions with full-coverage classification and recovering lost yield, explore our resources.
Quantify Your Own Yield Recovery Potential
In the meantime, to understand what the yield opportunity looks like in your production environment, the next step is to quantify it using your own parameters. We created an interactive ROI calculator to help you quantify:
- Sampling amplification
- Trigger probability
- Containment vs. true footprint
- Recoverable wafers and annual value
Discover in minutes:
- Current decision structure and its impact
- Over-containment volume
- Recoverable yield potential
- Annual financial upside from full-coverage review
